FIB-SEM画像のグラデーション補正機能紹介
FIB-SEM画像をセグメンテーションする上で課題となるグラデーションをスクリプトにより補正
FIB-SEM画像等に多く発生するグラデーションを補正することで、効率的にセグメンテーションが可能となるグラデーション補正用スクリプトをJSOLで開発しました。
FIB-SEM画像を使用した3Dモデルの構築
FIB-SEMとはFIB(Focused Ion Beam:集束イオンビーム)装置により試料を加工しながら露出した断面をSEM(Scanning Electron Microscope:走査型電子顕微鏡)により観察することで試料内部における構造の把握を可能にする装置です。FIBによる加工とSEMによる撮影を繰り返すことで得られた断面画像をSimplewareに取り込むことで試料内部の3次元的な観察や統計分析、有限要素モデルの作成など材料研究・開発に必要なデータを取得可能です。
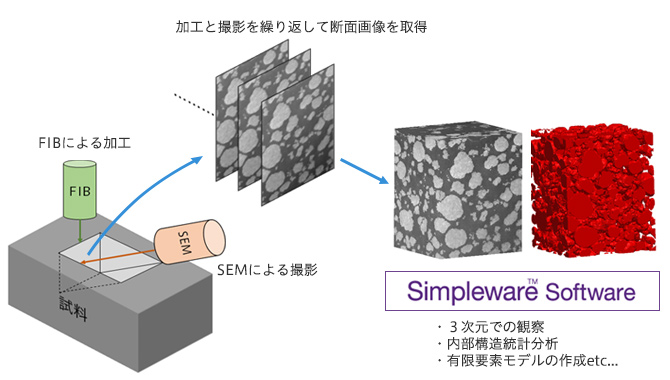 図1.FIB-SEM概要
図1.FIB-SEM概要
FIB-SEM画像に発生するグラデーション
しかしながらFIB-SEMによる内部構造の撮影によって得られる画像は撮像の都合上、画像内にグラデーションが発生しやすく、このグラデーションがグレースケール閾値による試料の母材と充填物のセグメンテーション作業に影響を与えます。
図2に示す例ではグラデーションの影響で画像上部の母材と下部の充填物のグレースケール値が同程度となっているため充填物をセグメンテーションすると不要な母材領域まで抽出されてしまいます。
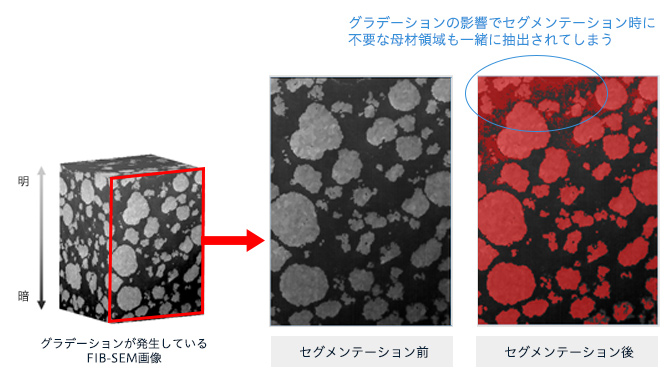 図2.グラデーションによる影響
図2.グラデーションによる影響
グラデーション補正機能
そこで今回、各断面画像のグレースケールの平均値からグラデーションを計算し、補正するスクリプトをJSOLが開発しました。このスクリプトを使用しグラデーションによる影響を緩和することで、より効率的なセグメンテーションが可能となります。
図3aの補正前画像では実際に画像の上から下にかけてグレースケール値が低くなっていることが確認できます。一方、今回のスクリプトで補正をかけた図3bでは補正により画像上下のグラデーションが抑制されており、容易に充填物のみを抽出することが可能となりました。
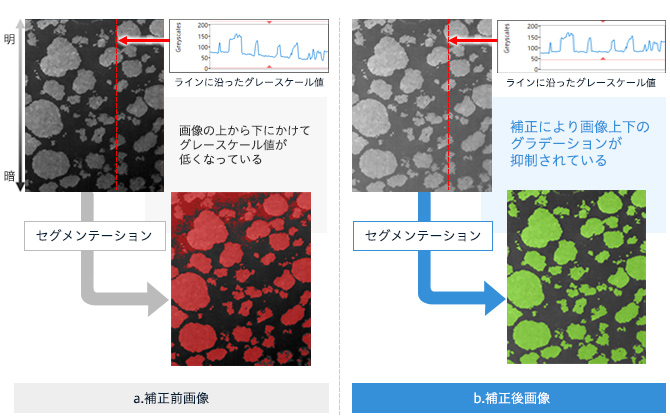 図3.グラデーション補正結果
図3.グラデーション補正結果
本製品に関するお問い合わせ
Simplewareは材料研究・開発の分野において多くの現場でご活用いただいております。ご訪問によるソフトウェア紹介や3次元画像のモデル化・分析に関するご相談も承っておりますので本製品にご興味のある方は弊社お問い合わせ窓口よりお問い合わせください。
Simplewareをすでにご利用いただいているユーザー様には本スクリプトを無償でご提供いたしますのでご興味のある方はSimplewareサポートまでお問い合わせください。
- ※株式会社JSOLはSimpleware Softwareの正規代理店です。
- ※Simpleware Software の開発元は、Synopsys, Inc.(米国)です。
- ※記載されている製品およびサービスの名称は、それぞれの所有者の商標または登録商標です。






