
[解析事例] LDA+U法による半導体バンドギャップの補正事例
- 量子化学・DFT
- 光学・電気・磁気
- マテリアルサイエンス
半導体のバンド構造をSIESTAで高精度に解析
パワー半導体は、電力系統における高圧・大電流に対応したスイッチング素子やインバータなどに広く利用されており、高耐電圧特性を持つ半導体です。半導体の耐電圧特性は、価電子帯と伝導帯を分けるバンドギャップの大きさで決まりますが、パワー半導体は、SiやGaAsのバンドギャップ幅に比べると、3倍程度の大きなギャップを持つことから、ワイドギャップ半導体とも呼ばれています。このため、シミュレーションによる半導体を利用した材料設計では、バンドギャップを精度良く見積もることができることが前提となりますが、密度汎関数法による第一原理計算は、対象によっては実験結果よりもかなり小さなギャップを予想します(図1)。
 図1.GGA法による半導体のバンド計算結果(左Si/右GaAs)
図1.GGA法による半導体のバンド計算結果(左Si/右GaAs)
補正のないGGA法の計算によるバンドギャップの大きさは、Siが0.72eV(実験値1.12eV)で、GaAsが0.37eV(実験値1.42eV)となった。これらは一般的な補正のないDFTが与える予測値とほぼ同じ結果である。
これは密度汎関数法が電子を過剰に非局在化するためであることが知られており[1][2]、この欠点を改善する手法のひとつにLDA+U法があります[3]。
LDA+U法では、適用された軌道にある2つの電子が同一のサイトに来ると斥力を生じてエネルギーがUだけ上昇します。この結果、電子の過剰な非局在化が抑えられてバンド構造も回復します。
本事例では、間接遷移型半導体であるSiと4H-SiC、直接遷移型半導体であるGaAsとGaNについて、LDA+U法を適用してバンドギャップの解析を行いました。 いずれの半導体も価電子帯を構成するp軌道に対して、LDA+U法を適用します。Siは3p軌道が対象となりますが、その他の3種類の半導体は化合物半導体のため、価電子帯を構成するp軌道を持つ元素を選択する必要があります。ここでは各元素の電気陰性度の違いに着目します。GaAsでは、Asの方が電気陰性度が大きく、Gaの4p軌道の電子は、Asの4p軌道に引き付けられます。このためAs由来の4p軌道が価電子帯を形成します。GaNではNの方が電気陰性度が大きく、N由来の2p軌道が価電子側を形成します。SiCはともにIV族元素ですが、SiよりもCの方が電気陰性度が大きく、C由来の2p軌道が価電子帯を形成します。 図2~4に化合物半導体の各元素に由来するp軌道の部分状態密度を表示します。いずれの結果も電気陰性度の大きい方の元素が価電子帯を形成していることが分かります。図5~8にLDA+U法の有無によるギャップ近傍のバンド構造を示します。このようにパラメータUを調整することで、実測に近いエネルギーギャップを得ることができます。
-
- [1]J. P. Perdew, R. G. Parr, M. Levy, and J. L. Balduz, Jr., Phys.Rev. Lett. 49, 1691 (1982).
- [2]O. Gunnarsson and K. Scbonhammer, Phys. Rev. Lett. 56,1968 (1986).
- [3]V. I. Anisimov, J. Zaanen, and 0. K. Andersen, Phys. Rev. B44, 943 (1991).
 図2.GaAsにおけるGaとAsの4pバンド
図2.GaAsにおけるGaとAsの4pバンド
 図3.GaNにおけるGaとNの4pバンドと2pバンド
図3.GaNにおけるGaとNの4pバンドと2pバンド
 図4.SiCにおけるSiとCの4pバンドと2pバンド
図4.SiCにおけるSiとCの4pバンドと2pバンド
 図5.Si:間接遷移型 実験値1.12eV
図5.Si:間接遷移型 実験値1.12eV
 図6.GaAs:直接遷移型 実験値1.42eV
図6.GaAs:直接遷移型 実験値1.42eV
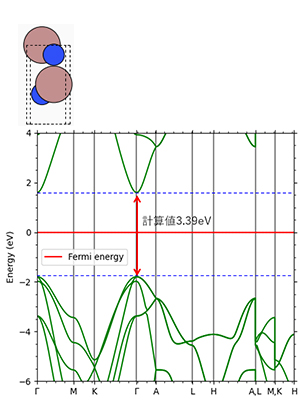 図7.GaN:直接遷移型 実験値3.39eV
図7.GaN:直接遷移型 実験値3.39eV
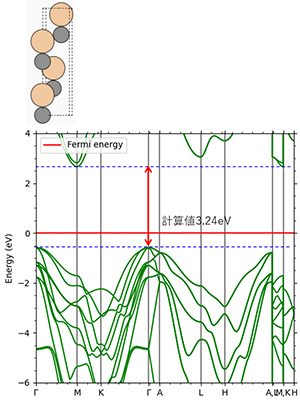 図8.4H-SiC:間接遷移型 実験値3.26eV
図8.4H-SiC:間接遷移型 実験値3.26eV
事例一覧
- ※記載されている製品およびサービスの名称は、それぞれの所有者の商標または登録商標です。





